1. Photo Lithography Process란?

<Photo Lithography Process>
https://y-sandy.blogspot.com/2017/04/photolithography-word-lithography-comes.html
Photo Lithography 공정이란 패턴이 새겨진 Mask에 빛을 조사하여 원하는 패턴을 Wafer에 새기는 것으로 반도체 공정 시간의 60%를 차지하는 매우 중요한 공정이다.
※관련 용어 정리
-Mask: 원하는 패턴을 웨이퍼에 새기기 위해 제작된 Plate
-PR(Photo Resist, 감광제): 특정 파장대의 빛에만 반응하는 물질로 Positive PR(빛을 받은 부분이 용매에 의해 제거)과 Negative PR(빛을 받지 않은 부분이 용매에 의해 제거)이 있다. 또한, 보통 소수성 성질을 가진다.
└> Positive PR이 Step coverage와 해상도가 더 좋고 최소 선폭이 더 좁아(0.5um) 주로 사용된다.
-Solvent: PR을 구성하는 물질 중에 하나로 외부의 빛을 흡수해 PR을 보호한다. 또한, PR의 점도를 결정한다.
-Polymer(Resin): PR을 구성하는 물질 중에 하나로 현상 후에 Pattern으로 남아있다.
-PhotoActive Compound(PAC, Sensitizer): 빛 에너지에 의해 실질적으로 반응하는 물질로 현상 과정에서 Polymer를 녹게 하거나(Positive) 녹지 않게 하는(Negative) 역할을 한다.
-Yellow Room: 빛에 민감한 PR을 다루는 Photo Lithography 공정을 진행하기 위해서는 PR에 광학적 영향이 적은 붉은 빛의 조명을 사용해야 하는데, 붉은 빛의 조명은 사람의 정신 건강에 유해하기 때문에 대신 노란 빛의 조명으로 Clean room을 밝힌다.
-분해능/해상도(Resolution): Wafer 표면에 빛을 전사 할 수 있는 최소한의 크기를 나타내는 단위로 분해능이 작을수록 더욱 미세한 공정이 가능하다.

<Resolution>
https://www.slideshare.net/shashikant122/a-brief-description-of-photolithography
*R: Resolution
*λ: 노광 파장
*K1: 비례상수
*NA: 렌즈의 개구 수 -> NA=R(렌즈의 반지름)/F(초점거리)
└> NA와 R은 반비례 관계이기 때문에 NA가 클수록 해상도가 좋아진다. 이러한 NA를 키우기 위해서는 렌즈의 크기를 키우거나 렌즈의 굴절률을 증가시켜야 한다.
-DOF(초점심도): 렌즈를 통과해 축소된 빛이 초점을 맞출 수 있는 범위이다. 렌즈의 구경이 클수록 DOF가 커지고 초점이 더욱 선명해 진다.

http://www.teasystems.com/WhitePapers/WeirPW_CalculatingBestFocus.htm
* NA가 작을수록 초점심도는 커진다. 하지만, NA가 작아질수록 분해능은 안 좋아지기 때문에 초점심도와 분해능은 반비례 관계이다. 이러한 반비례 관계를 극복하고자 다양한 방식의 노광공정이 있다.
2. Photo Lithography Process 순서
1) Wafer preparation
본격적인 Photo Lithography 공정에 앞서 공정에 적합한 성질을 가진 Wafer 표면을 만드는 과정이다.
-Wafer Cleaning: 웨이퍼 표면 불순물 제거한다.
-Dehydration Baking: 수분은 소수성인 PR과 Wafer 표면 사이의 점착력을 떨어트리기 때문에 Baking을 통해 수분을 제거한다.
-Wafer Prime: Wafer의 표면이 친수성일 경우에 소수성인 PR과의 점착력이 떨어지게 된다. 이를 해결하기 위해서 HDMS를 Wafer 표면에 분사해 소수성으로 바꿔준다.
(친수성 Wafer 표면 -> 소수성 Wafer 표면)
2) Spin Coating
PR을 Wafer 표면에 균일하게 도포하는 과정이다. 이 과정에서 PR 용액의 점성계수는 점성이 낮을수록 Spin 속도가 빨라질수록 두께가 얇아지는 특징이 있다.
-Spin Coating Defects

<Spin Coating Defects>
http://large.stanford.edu/courses/2007/ph210/hellstrom1/
a) Particle로 인하여 발생하는 defect
b) 기판이 덜 Baking 되어 잔류해 있던 수분에 의해 PR 용액이 덜 퍼진 defect
c) PR용액이 부족하여 발생하는 defect
3) Soft Bake
Soft Bake는 PR Coating 후에 hot plate를 이용해 Wafer에 열을 가하는 과정으로 PR에 있는 휘발성 물질 Solvent를 제거하고, PR의 밀도를 증가 시킨다.

<Soft bake>
https://slideplayer.com/slide/4538271/
-Soft Bake의 목적
a) Mask에 의해 Wafer에 발생하는 오염 감소
b) Wafer에 의해 Mask에 발생하는 오염 감소
c) 노광 공정 중에 발생하는 N2 Bubbling 현상 방지
d) Wafer와 PR의 점착력 향상
e) 현상 공정 중에 발생하는 Dark Erosion 현상 방지
f) PR의 구성요소인 Solvent가 열에 의해 증발하여 PR의 밀도가 증가한다.
※이때 너무 높은 온도로 가열하거나 너무 긴 시간을 가열하면 용해도가 감소해 현상 공정에서 현상률이 떨어진다.
4) Exposure(노광)
Pattern이 새겨진 Mask(Reticle)에 특정한 파장의 빛을 통과시켜 Wafer 표면의 PR(감광액)과 반응시켜 Wafer 표면에 Pattern을 형성시키는 공정이다. 이때 Mask의 패턴을 정확하게 위치시켜 Wafer 표면에 정확한 Pattern을 생성하도록 Alignment 장비의 Align Key를 이용해 정렬한다. 또한, Dose(조사하는 빛의 양)을 조절해 PR 반응의 정도를 조절한다.
Mask 패턴과 Wafer를 배치하는 방법에 따라 Contact mode, Proximity mode 그리고 Projection mode가 있는데 주로 Projection mode를 사용한다. 또한, Stepper 방식과 Scanner 방식이 Projection mode의 대표적인 예이다.

<Scanner&Stepper>
https://www.facebook.com/ASMLKR/photos/a.159892774060186/1453971981318919/?type=3&theater
-Stepper: 마스크와 Wafer의 크기가 1:1로 제작되며 1:1 비율로 노광하는 방식으로 속도는 빠르지만, 정밀도가 Scanner에 비해 많이 떨어져 현재는 거의 이용하지 않는다.
-Scanner: DUV 광원을 이용해 노광시키며 Reticle(Mask)를 Wafer 이동 방향의 반대 방향으로 이동 시키며 한 줄씩 노광하는 방식이다. 노광 사이즈는 N:1로 축소 노광하기 때문에 초미세공정에서 많이 사용되지만, 한 줄씩 노광하기 때문에 속도가 느리다.
5) PEB (Post Exposure Bake)
PEB는 노광공정에서 Standing wave (정재파)로 Pattern 벽면에 생긴 물결무늬를 제거, 완화시키기 위해 Baking 해주는 과정이다. 또한, 노광에 의해 생성된 PR의 물리적 Stress를 감소시켜 준다. 이 과정을 통해 Resolution(분해능)을 높일 수 있다.
※Standing wave (정재파): PR 표면이 과다노출 되거나 과소노출 되면 반사된 빛에 의해 PR Pattern 벽면에 생기는 물결무늬이다. 이러한 defect를 완화시키기 위해 Soft Baking 보다 높은 120도에서 1분 동안 열처리를 하여 PAC를 확산시키고 확산된 PAC가 물결무늬의 골을 메꾸어 준다. 다른 방법으로는 BARC 방법이 있는데, PR층의 밑면에 빛의 반사를 막는 물질을 도포해 빛이 반사되며 일으키는 Standing wave 현상을 막아준다.

<Standing wave 현상>
https://www.tf.uni-kiel.de/matwis/amat/elmat_en/kap_6/backbone/r6_6_2.html
6) Development (현상)
실질적으로 Pattern의 형상이 드러나는 과정으로 현상액을 PR에 뿌려가며 노광된 PR을 선택적으로(Positive or Negative) 제거한다.
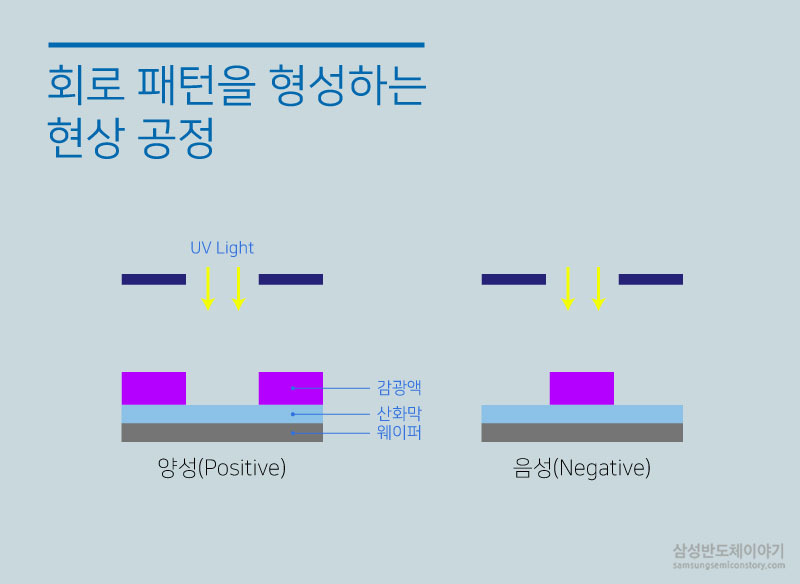
<Positive & Negative Development>
https://www.samsungsemiconstory.com/1601
7) Hard Bake
잔여 Solvent를 제거하고 PR을 건조시켜 PR의 점착력을 증가시키는 공정으로 Soft Baking보다 높은 온도에서 진행한다. 이 과정에서 PR 내부의 모든 용매와 기포를 제거하고 Pin hole과 같은 결함을 해결한다.
3. EUV (Extreme Ultraviolet)
EUV 공정이란 반도체의 미세화가 진행됨에 따라 기존의 분해능보다 더 높은 분해능을 필요로 해서 만들어진 공법으로 매우 짧은 파장의 빛을 이용해 Photo Lithography 공정을 진행하는 방식으로 10nm 미만의 패턴도 제작이 가능하다.
또한, EUV는 굉장히 예민해서 대부분의 고체나 액체 그리고 기체에도 흡수되기 때문에 공정은 반드시 진공에서 진행되어야 하며 기존에 사용되던 렌즈에도 흡수가 되기 때문에 10개 이상의 거울을 이용하여 공정을 진행한다.
장점은 10nm 이하의 초미세 공정이 가능하다는 것이고, 단점은 공정의 난이도가 굉장히 높고 생산 속도가 느린 것이다.